- home
- 제품소개
- 장비사업
Etching & Ashing System
Application : Semiconductor, LED, SAW Filter
Oxide, PR등 다양한 재료의 Etching or Remove 공정
Easy Maintenance / Simple Design & Compact Size / Excellent Throughput
Substrate : Wafer & Glass
System type : Cluster Type (Loadlock & Unloadlok / Process / Transfer chamber)
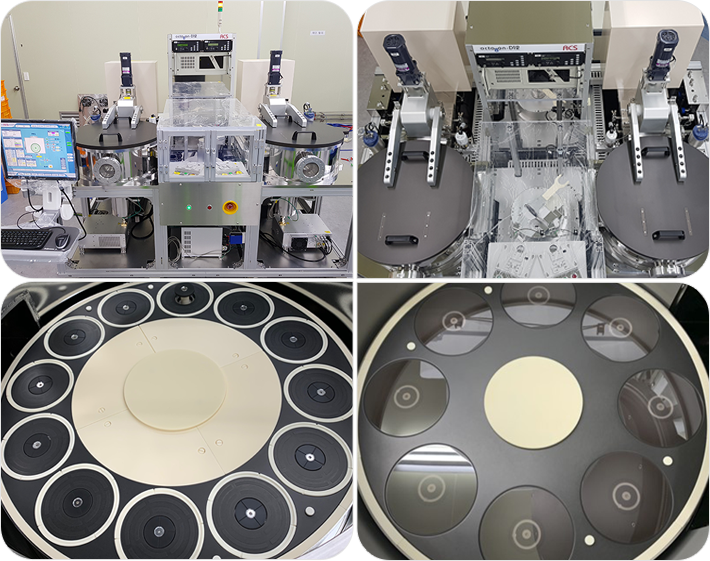
- Wafer Size : 2inch~6inch
- Wafer Type : Si, LT Wafer(180~250㎛)
- Process Application : Si-Oxide Etch, PR Ashing
- High Plasma Density : RIE Type RF Source
- Loading Capacity : 2Cassette, PM(4”wafer x 12ea or 8ea)
| Items | Specifications |
|---|---|
| System control | PC Control, Full automation |
| System type | Cluster type |
| Configuration | 1 Loading station (2Cassette, ATM Robot) 2 Process chamber |
| System foot-print | 3,000(W)×2,000(D)×2,000(H)mm (Include maintenance area) |
| Substrate size | 4Inch LT Wafer |
| Loading capacity | Loading station : Wafer 25pcs loading (Standard cassette) Process Chamber : Wafer 8pcs loading |
| Ashing material | PR |
| Power supply | Metal (Ti, Cu..) |
| Sputtering source | RF Power supply : 600W 13.56MHz, RIE Type |
| Vacuum system | Low vacuum, Dry pump 1set |
| Ultimate pressure | 2.0E-3 Torr (within 24hrs) |
| Ashing uniformity | Within ≤ 10%, Wafer to Wafer ≤ 5% |
| Ashing rate | ~ 20Å/s |
- Wafer Size : 2inch~6inch
- Wafer Type : Si, LT Wafer(180~250㎛)
- Process Application : Si-Oxide Etch, PR Ashing
- High Plasma Density : RIE Type RF Source
- Loading Capacity : 2Cassette, PM(4”wafer x 12ea or 8ea)